- Carborane Reinforced PS-b-P2VP Block Copolymer Nanopatterns
Green and Sustainable Materials R&D Department, Korea Institute of Industrial Technology, Cheonan, Chungnam 31056, Korea
*Division of Advanced Materials Engineering, Kongju National University, Cheonan, Chungnam 31080, Korea- Carborane을 이용한 PS-b-P2VP 블록공중합체 나노패턴의 식각 저항성 향상
한국생산기술연구원 친환경융합소재부문, *공주대학교 신소재공학부
Reproduction, stored in a retrieval system, or transmitted in any form of any part of this publication is permitted only by written permission from the Polymer Society of Korea.
Block copolymers self-assembly has been intensively studied because they offer a simple and low-cost nanopatterning method which can be applicable in various fields. Polystyrene-b-poly(2-vinyl pyridine) (PS-b-P2VP) is one of most commonly used block copolymer due to its advantages such as easy control of pattern morphology, large-area orientation, and simple process for metal substitution. However, since it is composed of only organic polymers, it has insufficient etching selectivity between two blocks required for pattern transfer. In this study, we show that with a simple process, carborane compound can be selectively introduced into the P2VP domain of PS-b-P2VP which can significantly improve the etching resistance of the P2VP block. This result can provide important clue to solve the common problem of low etching selectivity in block copolymers composed of organic materials, and therefore it is expected that the usefulness of block copolymers as various nanolithographic templates could be further expanded
블록공중합체를 이용한 저비용, 고효율 나노패턴 제조 기술은 다양한 분야에 활용성을 가지고 활발히 연구되고 있다. Polystyrenre-b-poly(2-vinyl pyridine)(PS-b-P2VP) 블록공중합체는 패턴 정렬의 용이성, 대면적 배향 가능, 금속 치환 가능 등의 장점으로 범용적으로 사용되는 블록공중합체이지만 유기물로만 구성되어 있기에 패턴 전사에 필요한 식각 선택도(etching selectivity)가 부족한 한계를 가지고 있다. 본 연구에서는 간단한 공정으로 carborane 화합물을 PS-b-P2VP의 P2VP 블록에 선택적으로 도입시킬 수 있는 방법을 제시하여 P2VP 블록의 식각 저항성을 크게 향상시킬 수 있음을 보였다. 이 연구 결과는 유기물로만 이루어진 대부분의 블록공중합체의 낮은 식각 선택도 문제를 극복하는데 중요한 단서를 제공해 줄 수 있을 것이며 향후 블록공중합체의 다양한 나노 패턴 주형으로서의 활용성을 더욱 넓힐 수 있을 것으로 기대한다
A simple process to improve etching selectivity of PS-b-P2VP block copolymer is proposed. It is demonstrated that carborane compound can be selectively introduced into the P2VP block of PS-b-P2VP and this process significantly improve the etching resistance of the P2VP block.
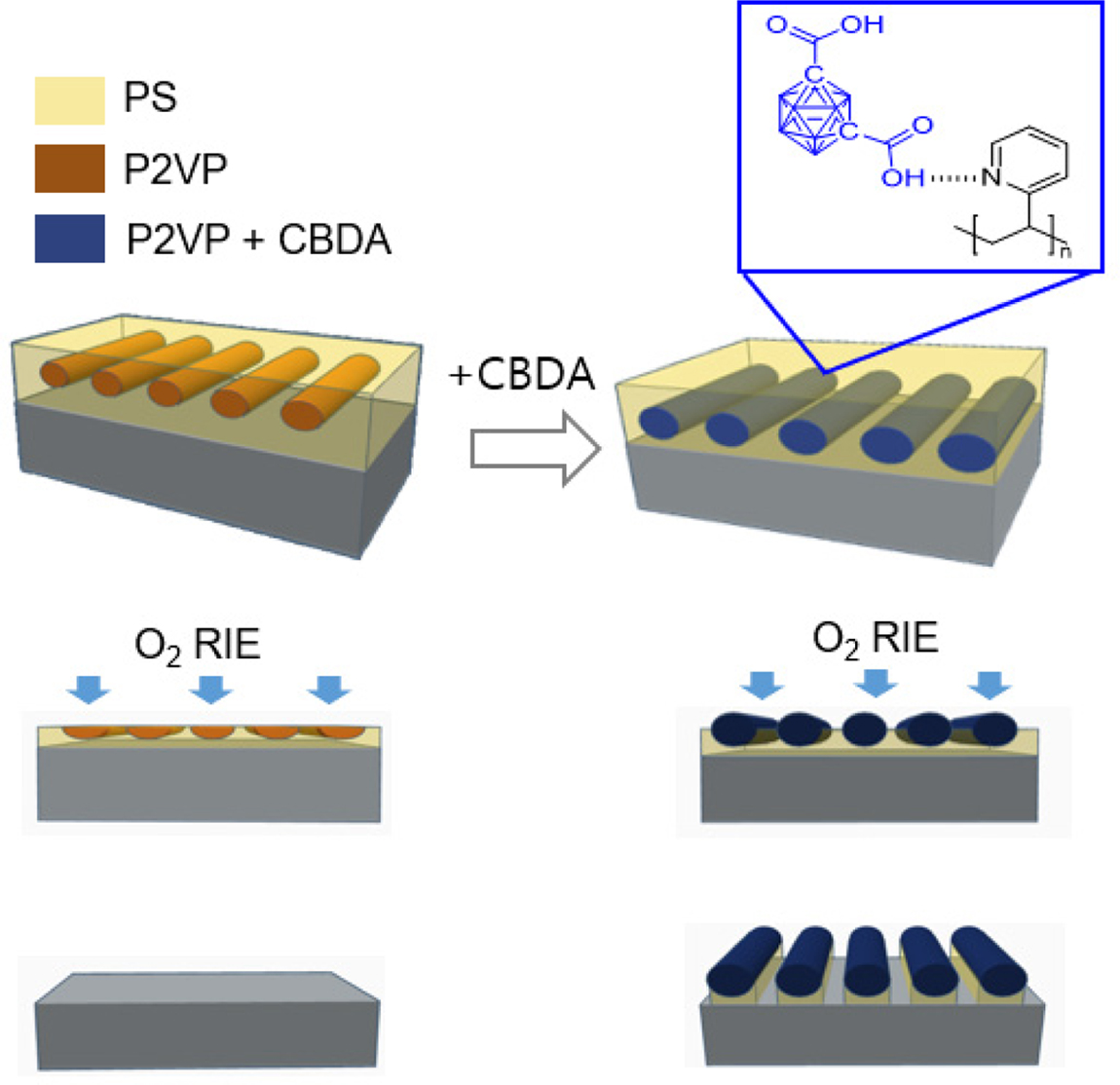
Keywords: block copolymer, nanopattern, nanolithography, carborane, etching selectivity
이 논문은 2018년 공주대학교 학술연구지원사업의 연구지원에 의하여 연구되었음.
블록공중합체는 구성하는 고분자 블럭의 비상용성에 기인하는 미세 상분리 현상을 이용하여 규칙적인 나노 구조체를 저비용, 대면적으로 제조할 수 있는 장점으로 인해 멤브레인 필터1,2 및 에너지 전자 소자,3-6 플라즈모닉 센서7,8 등 다양한 한 분야에 활용성을 가지고 활발히 연구되고 있다. 특히 블록공중합체는 박막형태로 제조되면 블록공중합체가 갖는 미세 패턴을 기판으로 전사하는 것이 가능하기 때문에 포토리소그래피를 대체할 차세대리소그래피로서 주목받으며 꾸준히 연구되어 왔다.6,9-11 블록공중합체의 나노 패턴은 일반적으로 두 종류의 고분자 블록이 미세 상분리를 통해 형성된 것이기 때문에 리소그래피의 마스크로 사용되기 위해서는 반드시 하나의 블록을 제거하는 공정이 필수적으로 선행되어야 한다. 따라서 블록공중합체의 구성 고분자를 선정할 때에는 고분자 블록의 분리를 위한 비상용성(χ: Flory-Huggins 상호작용 계수)을 고려함과 동시에 블록들 중 하나의 블록을 쉽게 제거할 수 있는 선별적 식각 가능 여부가 중요한 요소라 할 수 있다.
이와 같은 이유로 블록공중합체의 두 구성 고분자 블록 간의 식각 저항성의 대비를 확보하기 위한 많은 연구들이 진행되어 왔다. 예를 들면, 리소그래피로 많이 연구되고 있는 poly (styrene-b-methyl methacrylate)(PS-b-PMMA) 블록공중합체의 경우는 자외선 조사 시 PS 블록은 가교되고 PMMA 블록은 사슬이 절단되는 현상을 이용하여 UV 조사 후 PMMA의 선택적 용매인 acetic acid를 사용하여 PMMA 블록을 제거하고 PS 블록만 남겨 리소그래피 마스크로 이용하였다.12,13 하지만, 위와 같은 용매를 사용하는 습식 식각의 경우 패턴의 거칠기(roughness)가 커지거나 종횡비가 높은 패턴의 경우 습식 식각 공정 중 모세관 현상에 의해 무너지는 등 미세 패턴 제조에는 불리한 방식이어서 건식 식각이 더 선호된다. 블록공중합체의 건식 식각의 경우 일반적으로 O2 reactive ion etching(RIE)를 사용하여 유기 고분자 블록을 제거하게 되며 유기물 만으로 구성된 보통의 블록공중합체의 경우, 두 블록간의 식각 선택성이 크지 않아 리소그래피를 위한 마스크로써 사용성이 제한되는 문제가 발생한다. 이를 극복하기 위하여 식각 저항성이 큰 무기물을 한쪽 블록에 도입하여 블록공중합체의 식각 선택성을 향상시키기 위한 연구들이 많이 진행되었다. Gopalan, Nealey 연구팀에서는 polyhedral oligomeric silsesquioxane(POSS)를 포함하는 블록공중합체를 합성하여 자기조립을 통한 미세 패턴에 잘 형성됨을 보였고 POSS를 포함하는 블록이 다른 유기 블록에 비해 충분히 큰 식각 저항성을 가지고 있음을 보고하였다.14,15 하지만, 이러한 경우는 블록공중합체의 합성 단계가 복잡해지고 사용할 수 있는 고분자의 종류에도 제한을 받게 된다. 또 다른 연구로는 POSS와 같은 크고 복잡한 형태의 무기물이 아닌 polydimethylsiloxane (PDMS)와 같이 Si가 포함되어 있는 블록을 도입하여 식각 저항성을 향상시키는 연구도 많이 진행되었다.16-18 PS-b-PDMS 블록공중합체의 경우에는 O2 RIE에 의해 PS 블록이 쉽게 식각되는 반면 PDMS 블록은 Si가 포함되어 있어 O2 RIE에 의해 SiOx가 형성되어 식각 저항성이 확보되어 패턴 전사가 공정을 용이하게 진행할 수 있다.19-21 하지만, PS와 PDMS의 큰 표면 에너지 차이(γPS~40.7 mN·m-1, γPDMS~20.4 mN·m-1)로 인해 PDMS가 항상 필름 표면에 층을 이루기 때문에 기판에 수직 배열의 실린더나 라멜라 같은 구조를 얻기가 어렵다는 한계점이 있다.22 Darling 연구팀에서는 ALD(atomic layer deposition) 공정을 이용하여 PS-b-PMMA 블록공중합체의 PMMA 블록 내에 Al2O3를 성장시켜 PMMA의 식각 저항성을 향상시키는 연구를 보고하였다.23-25 합성 단계가 아닌 블록공중합체 필름을 형성한 후 무기물을 도입할 수 있다는 장점이 있지만 복잡한 진공 공정이 필요하다.
Polystyrene-block-Poly(2-vinyl pyridine)(PS-b-P2VP) 블록공중합체는 가장 널리 연구된 블록공중합체 중 하나로 PS-b-PMMA 블록공중합체 대비 Flory-Huggins 상호작용 계수 계수 값이 크며(PS-b-PMMA χ~0.06, PS-b-P2VP χ~0.18),26,27 특별한 표면 브러쉬 처리 없이도 실린더 구조의 수직, 수평 배열 조절이 용이하고 전단응력을 통한 대면적 패턴 정렬이 가능한 점 등의 장점이 있다.28,29 또한 P2VP 블록을 금속으로 치환할 수 있어 금속 나노선 및 금속 나노입자 패턴을 제조할 수 있기에 그 활용 분야가 아주 넓다.30,31 하지만, PS-b-P2VP 블록공중합체 자체는 유기 고분자로만 구성되어 있기에 두 블록 간의 식각 선택도가 작아 리소그래피로의 응용에는 한계가 있다. 물론 P2VP 블록을 금속으로 치환하면 식각 선택성이 높아지지만 금속 이온은 반도체 공정의 주요 오염원으로 작용할 수 있기에 리소그래피 마스크로 사용되기에는 적합하지 않다.15 Russell 연구팀에서는 선택적 용매를 이용해 P2VP 블록을 선택적으로 팽윤시켜 이 블록의 밀도를 낮게 하게 하면 식각 속도가 빠르게 되어 식각 선택도를 향상시킬 수 있다는 연구를 보고하였다.32 하지만, 고분자 블록의 화학적 변화 없이 밀도 조절만으로 이루는 식각 저항성 향상에는 그 한계가 있다.
본 연구에서는 PS-b-P2VP 블록공중합체의 P2VP 블록에 붕소를 포함하는 무기물인 carborane을 도입하여 식각 선택성을 향상시키는 방법을 제시하고자 한다. 이 때 carborane은 합성단계에 도입되는 방법이 아닌 기존의 PS-b-P2VP 블록공중합체를 이용하여 나노패턴을 제조한 후 carborane 용액에 침지시켜 P2VP 블록과 carborane 간의 2차 결합을 유도시키는 아주 간단한 공정을 통해서 식각 저항성을 향상시킬 수 있음을 보이고자 한다.
0.8 wt%의 polystyrene-block-poly(2-vinyl pyridine)(PS-b-P2VP, Mn=40-b-18 kg/mol, Polymer Source Inc., Canada), toluene 용액을 실리콘 기판 위에 3000 rpm으로 스핀코팅하여 약 55 nm 두께의 필름을 제조한다. 100 mL의 유리 바이알 바닥에 THF 용매 0.3 mL를 넣고 준비된 PS-b-P2VP 필름을 THF가 직접 닿지 않게 위치시킨 후 뚜껑을 덮고 2시간 동안 상온에서(25 oC) 용매 어닐링을 진행한다.
m-Carborane-1,7-dicarboxylic acid(CBDA, Sigma-Aldrich, USA)를 에탄올에 녹여 0.5~3 wt%의 CBDA 용액을 제조한 후 여기에 용매 어닐링을 마친 PS-b-P2VP 필름을 침지시켜 CBDA와 P2VP 사이의 수소결합을 유도한다. 10분~1시간 후에 PS-b-P2VP 필름을 꺼낸 후 에탄올로 린스를 한 후 질소건으로 건조시킨다. P2VP 블록의 선택적 팽윤을 통한 surface reconstruction을 위해서는 용매 어닐링을 진행한 PS-b-P2VP 필름을 에탄올에 30분간 담근 후 꺼내어 질소건으로 남아 있는 용매를 빠르게 건조시킨다.
식각 정도를 알아보기 위한 P2VP 필름은 1 wt% P2VP(Mn =106 kg/mol, Polymer Source Inc., Canada), 에탄올 용액을 스핀코팅하여 필름을 제조 후 용매를 propylene glycol monomethyl ether acetate(PGMEA)를 사용하여 제조한 1 wt% CBDA 용액에 1시간 동안 침지시킨 후 꺼내어 PGMEA로 린스 후 건조시켰다. 모든 공정은 상온(25 oC)에서 진행하였다.
식각은 준비된 PS-b-P2VP 필름을 O2(90 W, 10 sccm)의 조건에서 정해진 시간동안 RIE(Tergeo, PIE Scientific, USA)를 하여 진행한다. 필름 표면 모폴로지는 SEM(Sigma500, Carl Zeiss, Germany)을 이용하여 관찰하고 표면 성분 분석은 XPS (K-Alpha, Thermo fisher scientific, source: Al Ka, USA)을 이용하였다. 패턴의 선폭과 주기는 각 조건에서 얻은 2.3 μm× 1.6 μm 면적의 SEM 이미지 분석을 통하여 측정하였다. 선폭의 경우 이미지 마다 20군데의 지점을 측정하여 평균하였고 주기의 경우 5군데 지점에서 10개의 실린더를 묶어서 폭을 측정하고 평균한 후 주기로 환산하였다. P2VP 필름의 두께는 SEM cross section 이미지를 통해 측정하였다.
실험에서 사용된 블록공중합체는 분자량이 40-b-18 kg/mol 인 PS-b-P2VP로 주기가 약 39 nm인 실린더 모폴로지를 형성하는 블록공중합체이다. Toluene 용매를 사용하여 0.8 wt%의 PS-b-P2VP 용액을 제조하여 실리콘 기판에 약 55 nm의 두께로 스핀코팅 후 THF로 용매 어닐링 공정을 진행하면 PS가 매트릭스이고 P2VP가 기판에 평행한 실린더 형태의 나노 구조체를 가지는 필름이 형성된다(Figure 1(b-i)). 이후에 패턴 전사를 위해서는 한 블록을 선택적으로 식각한 후 리소그래피 마스크로 사용해야 한다. 하지만, PS 블록과 P2VP 블록은 둘 다 유기물로만 구성되어 있기 때문에 O2 RIE에 대한 선택적 식각성이 없어서 Figure 1(b)의 (i)-(ii)-(iii) 그림에서 묘사한 바와 같이 미세패턴이 발현되지 않는다. 그 실험 결과를 Figure 2(a)에 나타내었다. Figure 2(a-i)과 2(a-ii)는 실린더 모폴로지가 형성된 PS-b-P2VP 필름을 O2 RIE로 각각 60초, 90초 식각한 후 SEM으로 관찰한 결과이다. 60초 식각 경우는 필름이 거의 제거되고 패턴의 흔적만 겨우 관찰할 수 있는 수준이고 90초 식각의 경우는 필름에 아무것도 남아 있지 않은 모습이었다. PS와 P2VP 블록 사이의 O2 RIE에 대한 식각 선택성이 없음을 확인할 수 있었다.
Carborane은 붕소와 탄소, 수소 등이 입체적인 구조를 이루고 있는 클러스터 화합물로 자외선(UV) 특히 극자외선(EUV)에 대한 투과도가 높기에 리소그래피용 레지스트 등으로도 활용성이 많은 물질이다.33,34 본 연구에서는 Figure 1(a)에 보인 것처럼 산 형태의 carborane dicarboxylic acid(CBDA)와 P2VP 블록 간의 수소결합을 유도하여 P2VP 블록의 식각 저항성을 향상시키고자 하였다. Figure 1(b)의 (i)-(iv)-(v)-(vi)의 과정은 본 연구의 개념을 간략히 나타내고 있다. Figure 1(b) (i)와 동일한 공정으로 PS-b-P2VP 미세 상분리 구조를 얻은 후 CBDA/에탄올 용액에 PS-b-P2VP 필름을 침지시켜 CBDA와 P2VP 블록 사이의 수소결합을 유도하였다. 비슷한 원리로 PS-b-P2VP나 PS-b-P4VP 블록공중합체 용액에서 특정화합물과 P2VP나 P4VP 블록의 선택적 수소 결합을 유도하여 해당 블럭의 부피를 크게 하여 블록공중합체의 주기나 모폴로지를 변화시키는 연구 결과들은 보고된 바 있다.35,36 본 연구에서는 용액 상태가 아닌 상 분리가 이루어진 필름 상태에서 수소결합을 유도하였다. 이를 위해 P2VP의 선택적 용매인 에탄올을 CBDA의 용매로 사용하여 필름 내의 P2VP 사슬이 에탄올에 의해 선택적으로 팽윤되어 CBDA 분자가 P2VP 사슬 사이로 쉽게 확산되어 둘 사이의 수소결합을 쉽게 이룰 수 있도록 하였다. 이 때 PS 블록은 에탄올에 의해 팽윤되지 않기 때문에 사용되는 PS-b-P2VP 블록공중합체의 주기 및 모폴로지를 유지한 채 간단한 침지 공정만으로 CBDA 도입을 진행할 수 있는 장점이 있다.
Figure 2(b-i)~(b-vii)는 1% CBDA 용액에서 1시간 동안 침지 처리한 PS-b-P2VP 블록공중합체 필름을 각 0초, 60초, 90초, 120초, 180초, 300초, 600초 동안 O2 RIE로 식각한 후 SEM으로 관찰한 것이다. CBDA처리를 하지 않은 PS-b-P2VP 필름은 Figure 2(a-i), Figure 2(a-ii)처럼 식각 시간 60초, 90초만에 PS 블럭과 P2VP이 구분 없이 모두 제거되는 반면 CBDA 처리한 필름은 O2 RIE 식각 60초(Figure 2(b-ii)), 90초(Figure 2(b-iii)) 후에도 P2VP 상이 또렷하게 남아있는 것을 확인할 수 있고 O2 RIE 식각 시간을 더 늘려 300초, 600초 후에도 P2VP 선이 얇아졌지만 여전히 남아 있는 것을 볼 수 있다. Figure 2(c-i)~(c-v)는 CBDA 용액이 아닌 순수한 에탄올에 30분간 침지시킨 후 O2 RIE 식각을 0초, 60초, 90초, 120초, 150초 진행한 결과를 나타낸 것이 다. Russell 연구팀에서 제시했던 바와 같이 PS-b-P2VP 블록공중합체 필름을 에탄올과 같은 선택적 용매에 침지시킨 후 건조하면 팽윤되었던 P2VP 블록이 다시 수축하면서 실린더 내부에 공간이 생기면서 표면 모폴로지가 변화하는 surface reconstruction 현상이 일어난다.32 Figure 3(c-i)에서 볼 수 있듯이 P2VP 실린더 내부의 빈 공간이 표면까지 노출되며 surface reconstruction이 진행된다. 이 상태에서 O2 RIE 식각을 진행하면 P2VP 블록의 밀도가 낮기 때문에 상대적으로 PS 블록 대비 O2 RIE 식각 저항성이 낮아서 P2VP 영역이 식각되고 PS 영역이 남아있게 된다(Figure 3(c-ii)).32 PS-b-P2VP 필름을 CBDA 처리를 하는 과정에서 surface reconstruction을 위해 사용하였던 용매와 동일한 용매인 에탄올을 사용하였지만 Figure 3(b-i)에서 볼 수 있듯이 CBDA 처리 과정에서는 surface reconstruction 현상이 나타나지 않았다. 이는 P2VP 블록이 에탄올에 의해 팽윤되었지만 CBDA 분자가 팽윤된 사슬 사이에 들어가 P2VP와 결합하여 부피를 차지하기 때문에 용매의 건조에 의한 P2VP 블록의 급격한 부피 수축이 일어나지 않기 때문인 것으로 여겨진다. 물론 CBDA처리로 인해 P2VP 실린더의 부피 팽창은 어느정도 발생하겠지만 이는 전체적인 선형패턴에 큰 영향을 미치지 않는다.30
아무 처리하지 않은 PS-b-P2VP 필름과 에탄올 침지 처리를 한 PS-b-P2VP 필름의 O2 RIE 60초 식각 후의 표면 모폴로지를 비교하면(Figure 2(a-i) vs Figure 2(c-ii)) 에탄올 처리한 필름의 식각 선택성이 향상된 것을 확인할 수 있다. 하지만, 에탄올 처리한 샘플도 O2 RIE 90초 식각부터는 선 패턴의 경계가 확실하지 않은 것이 보이고 120초 식각 처리 후에는 패턴이 거의 남아있지 않았다. 이는 CBDA 처리를 하고 같은 시간 O2 RIE 식각 처리를 한 샘플과 비교하였을 때 에탄올 처리를 통한 식각 선택성 향상의 효과는 한정적이고 CBDA처리를 통한 PS-b-P2VP 필름의 식각 저항성 및 식각 선택성 향상 효과가 훨씬 우수함을 보여준다.
Figure 3(a)는 아무 처리 안한 샘플, 에탄올 처리한 샘플, CBDA 처리한 샘플 간의 시간에 따른 O2 RIE 식각 정도를 비교하기 위해 식각 시간에 따른 선폭을 나타낸 그래프이다. 아무 처리하지 않은 샘플은 Figure 2(a)에서 보인 바와 같이 O2 RIE에 대한 식각 선택성이 거의 없기 때문에 선폭을 0으로 나타내었다. 에탄올로 처리한 샘플은 O2 RIE 60초 식각 후 선폭이 약 30 nm, 90초 식각 후에는 선폭이 약 28 nm로 측정되었고 120초 식각 후에는 선패턴이 거의 남아있지 않았다. 이 때 90초 식각한 샘플의 경우(Figure 2(c-iii))에는 선 패턴의 경계가 불분명하여 패턴 전사를 위한 마스크로의 사용은 어려운 상태이다. CBDA 처리한 샘플의 경우에는 O2 RIE 60초 식각 후에는 선폭이 약 22 nm, 90초 식각 후에 약 17 nm, 120초 후 약 15 nm, 180초 후 13.5 nm로 선폭이 식각 시간에 따라 점진적으로 줄어들어 식각 시간을 통해 선폭을 조절할 수 있음을 확인할 수 있었고, 150초 식각 후(Figure 2(b-v))에도 패턴 전사를 위한 마스크로 사용할 수 있을 정도로 선패턴이 명확하게 남아있음을 확인할 수 있다. 3가지 조건의 PS-b-P2VP 필름(아무 처리 안한 샘플, 에탄올 처리한 샘플, CBDA 처리한 샘플)을 모두 O2 RIE 60초 식각 후 주기를 측정한 결과 Figure 3(a) inset 그래프에서 보인 바와 같이 모두 약 39 nm로 거의 동일하게 측정되어 CBDA 처리 후에도 PS-b-P2VP 패턴 주기는 변화 없이 유지됨을 확인할 수 있다.
CBDA에 의한 P2VP의 식각도(etch rate) 변화를 직접적으로 확인하기 위해 순수 P2VP 필름을 제조 후 CBDA 처리한 샘플과 안한 샘플의 식각에 따른 두께 변화를 측정하였다. 이 때 순수 P2VP 필름은 에탄올 용매에 녹기 때문에 CBDA는 용해시키면서 P2VP는 녹이지 않는 PGMEA 용매를 사용하여 1 wt% CBDA 용액을 제조하였다. PGMEA는 에탄올에 비해 P2VP 사슬을 덜 팽윤시키기에 CBDA의 사슬 내 침투 효과는 약해질 수 있어 블록공중합체 실험과는 차이가 발생할 수 있다. Figure 3(b)에 두가지 샘플의 식각에 따른 두께 변화를 측정하여 나타내었다. 아무 처리하지 않은 P2VP 필름의 식각도는 평균적으로 약 0.25 nm/sec로 나타났고 CBDA 처리한 P2VP 필름의 식각도는 평균적으로 약 0.12 nm/sec로 낮게 나타났다. 하지만, CBDA 처리한 P2VP 필름의 식각에 따른 두께 변화를 자세히 살펴보면 처음 60초 동안 필름 두께 감소가 빠르고 그 이후는 완만하게 감소함을 볼 수 있다. 이는 초기 식각 기간 동안 유기물인 P2VP가 식각되어 없어져 필름두께가 빨리 감소하고 그 이후에는 무기물인 CBDA 성분이 남아 식각도가 더욱 낮아지는 것으로 추측할 수 있다.
CBDA를 용액 침지 방법으로 도입하였을 때 CBDA가 필름 내부까지 잘 도입되어 있는지를 확인하기 위해 샘플 표면을 식각 후에 성분 분석을 진행하였다. 앞선 실험 방법과 동일하게 용액 어닐링으로 미세 상분리까지 진행시킨 PS-b-P2VP 블록공중합체 필름을 1% CBDA/에탄올 용액에 1시간 동안 침지시킨 후 순수 에탄올로 세척 후 O2 RIE로 60초 식각한 샘플을 XPS를 이용하여 표면의 붕소 성분을 분석하였다. XPS에서 나타나는 붕소의 1s 피크는 강도가 아주 약하고 실리콘의 2s 피크와 겹쳐 관찰이 어렵기 때문에 붕소의 KLL Auger 피크를 관찰하였다.37 그 결과 Figure 3(c)에서 볼 수 있듯이 1310 eV 부근에서 나타나는 붕소의 KLL Auger 피크가38 관찰됨을 확인하였고 이는 carborane이 필름 내부까지 잘 침투되어 있음을 나타내준다.
이번에는 CBDA 용액 침지 방법의 최적 실험 조건을 찾기위해 CBDA 용액의 농도 및 침지 시간을 변화시켜 P2VP의 식각 저향성 향상 정도를 비교하였다. CBDA 용액의 농도는 각각 1%, 0.5%, 침지 시간은 상온에서 1시간, 30분, 10분으로 변화시켜가며 실험을 진행하였으며 모든 샘플은 동일하게 O2 RIE 180초 식각 후 SEM으로 남아 있는 패턴을 관찰하였다. Figure 4에서 볼 수 있듯이 1% CBDA 용액을 사용할 때는 침지 시간을 30분(Figure 4(b))까지 줄여도 1시간 침지한 샘플(Figure 4(a)과 거의 차이가 없이 P2VP의 식각 저항성이 유지되었다. 하지만, 침지 시간은 10분까지 줄이게 되면 Figure 4(c)에서 볼 수 있듯이 30분 동안 처리한 샘플에 비해 남아있는 선 패턴의 선명도가 크게 줄어드는 것을 볼 수 있다. CBDA 용액의 농도를 0.5%로 줄여서 실험을 하면 침지를 1시간 동안(Figure 4(d)) 하여도 1% CBDA 용액으로 처리한 샘플에 비해 P2VP의 식각 저항성이 충분히 확보되지 않음을 볼 수 있었다. 0.5% CBDA 용액에서 30분(Figure 4(e)), 10분(Figure 4(f)) 동안 처리한 필름의 경우에는 식각 후 남아 있는 선폭이 더 가늘고 선 패턴들이 중간 중간 많이 끊겨 있는 것을 볼 수 있다. 이 결과들로 미루어 보아 PS-b-P2VP 블록공중합체 필름을 농도 1% 이상의 CBDA 용액에서 30분 이상 침지시켰을 때 CBDA와 P2VP 블록 간 수소 결합이 충분히 진행되어 높은 수준의 P2VP의 식각 저항성이 확보됨을 확인할 수 있었다.
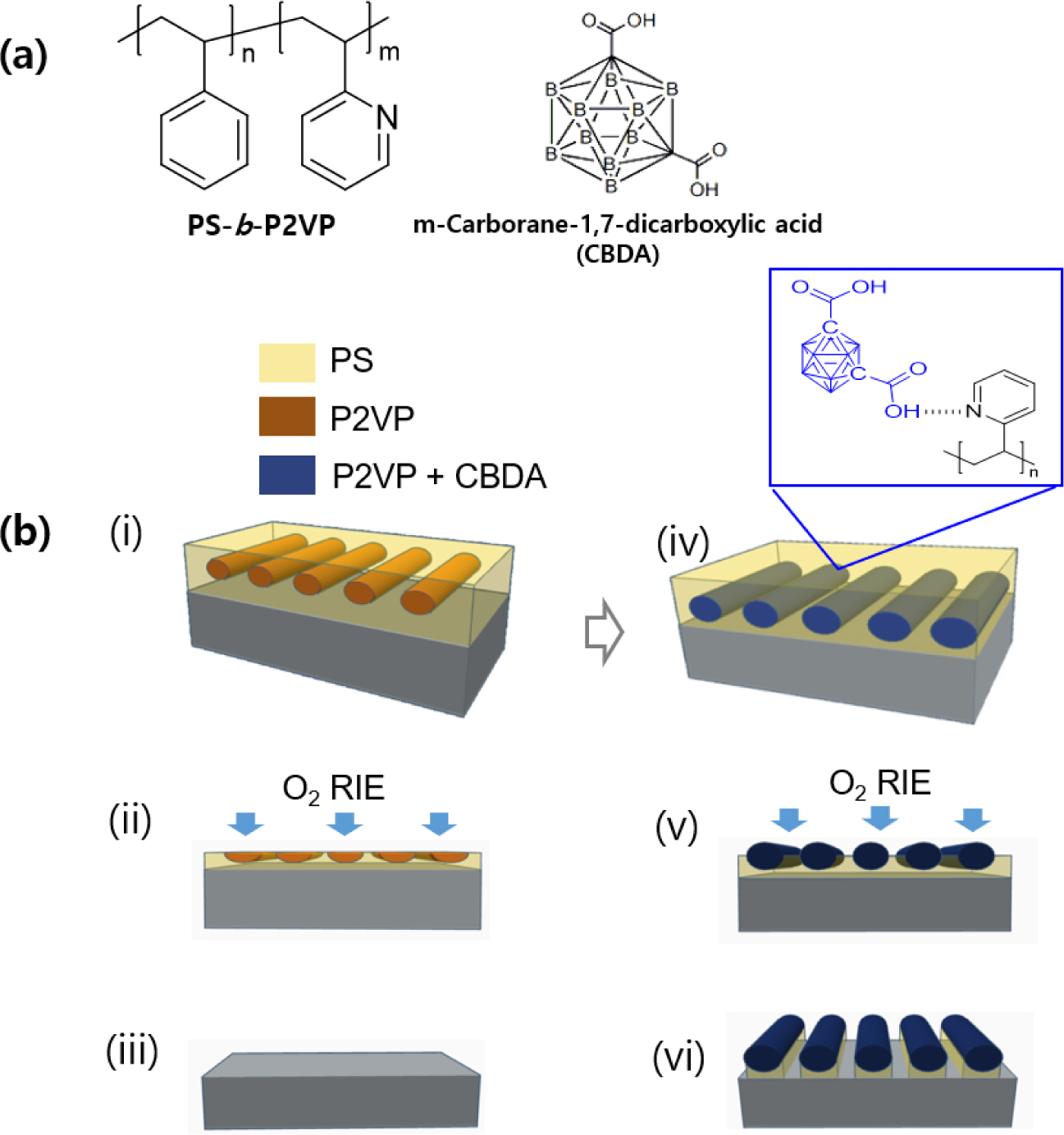
|
Figure 1 (a) Chemical structures of PS-b-P2VP and CBDA; (b) schematic illustration of O2 RIE process of PS-b-P2VP film (i)-(ii)- (iii) without CBDA treatment, and (iv)-(v)-(vi) with CBDA treatment. |
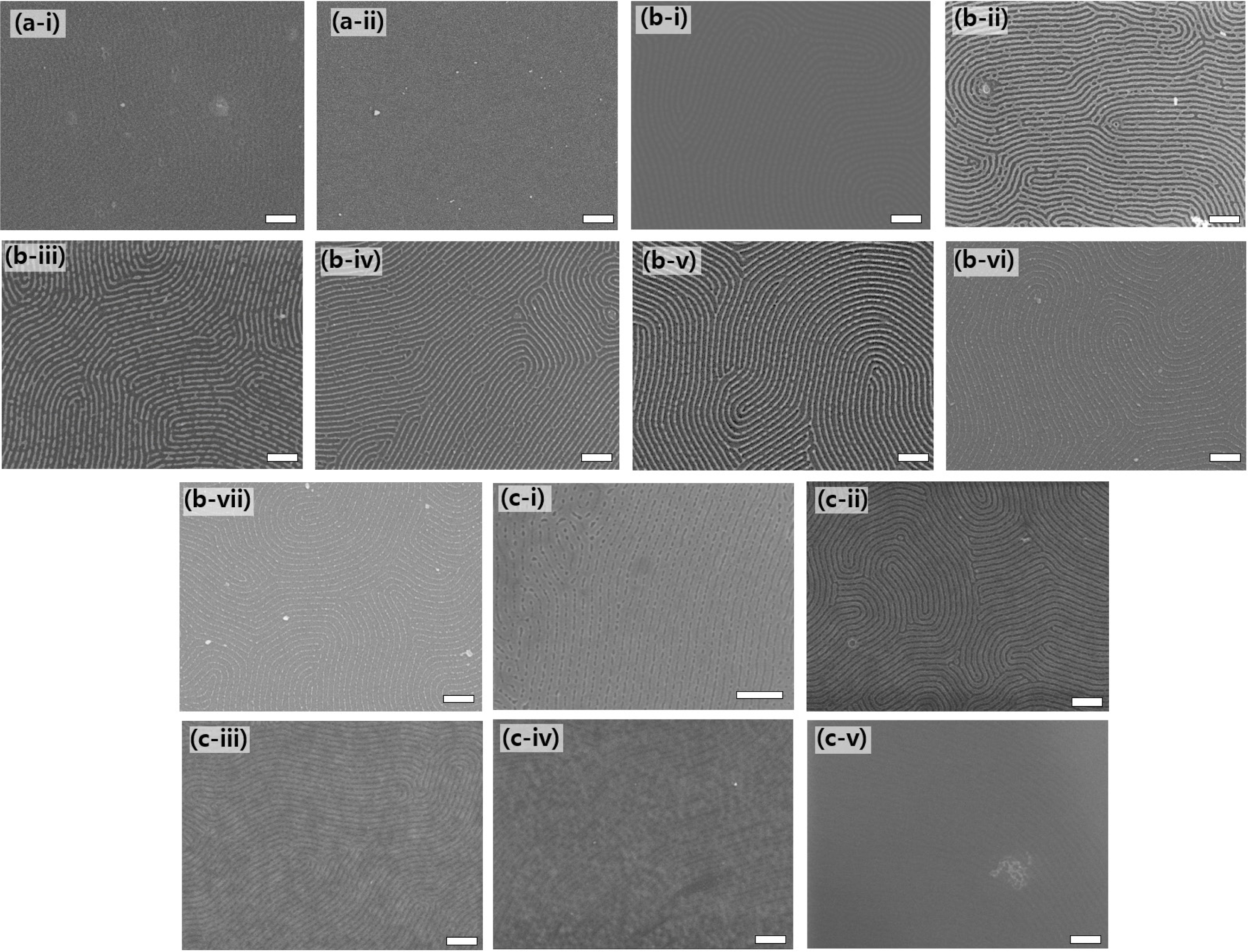
|
Figure 2 SEM images of (a) PS-b-P2VP film without any treatment after O2 RIE for (a-i) 60 s, (a-ii) 90 s; (b) CBDA reinforced PS-b-P2VP film after O2 RIE for (b-i) 0 s, (b-ii) 60 s, (b-iii) 90 s, (b-iv) 120 s, (b-v) 180 s, (b-vi) 300 s, (b-vii) 600 s; (c) PS-b-P2VP film with ethanol treatment after O2 RIE for (c-i) 0 s, (c-ii) 60 s, (c-iii) 90 s, (c-iv) 120 s, (c-v) 150 s. Scale bars are 200 nm. |
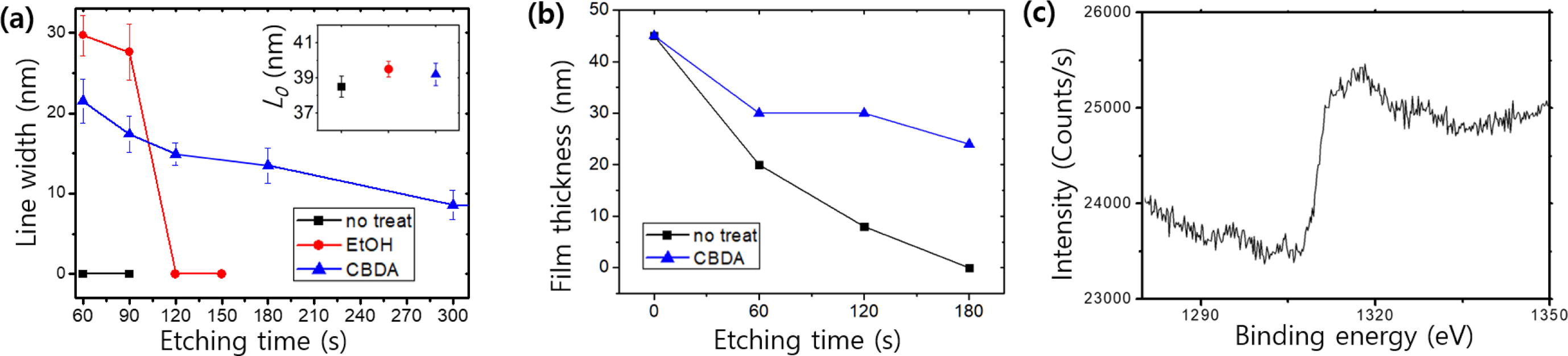
|
Figure 3 (a) Plot of P2VP line width of three different PS-b-P2VP films vs O2 RIE time. Inset indicates pattern periodicity of three different PS-b-P2VP films after O2 RIE for 60 s; (b) plot of thickness of CBDA treated P2VP film and P2VP film without treatment vs O2 RIE time; (c) XPS data of CBDA treated PS-b-P2VP films after O2 RIE for 60 s. |

|
Figure 4 SEM images of PS-b-P2VP film surface morphology after CBDA treatment at different CBDA concentration and immersion time (a) 1 wt% of CBDA solution for 1 h; (b) 1 wt% of CBDA solution for 30 min; (c) 1 wt% of CBDA solution for 10 min; (d) 0.5 wt% of CBDA solution for 1 h; (e) 0.5 wt% of CBDA solution for 30 min; (f) 0.5 wt% of CBDA solution for 10 min. All samples are etched with O2 RIE for 180 s. Scale bars are 200 nm. |
PS-b-P2VP 블록공중합체는 패턴 정렬의 용이성, 대면적 배향 가능, 금속 치환 가능 등의 장점으로 범용적으로 사용되는 블록공중합체이지만 PS와 P2VP 사이의 식각에 대한 선택도가 부족하여 패턴 전사에 한계가 있었다. 본 연구에서는 간단한 공정으로 PS-b-P2VP 블록공중합체 자기조립 나노패턴의 식각 선택도를 향상시키는 공정을 제시하였다. CBDA는 붕소를 함유한 무기물 화합물로 P2VP 블록과 수소결합을 이룰 수 있어서 PS-b-P2VP의 P2VP 블록의 식각 저항성을 선택적으로 향상시킬 수 있다. CBDA를 PS-b-P2VP 블록공중합체에 도입하는 공정은 어닐링을 통해 상분리가 완료된 필름 형태로 CBDA 용액에 침지시키는 방법으로 진행되었고 용매로 사용된 에탄올이 P2VP 사슬을 선택적으로 팽윤시켜 CBDA가 P2VP와 용이하게 결합할 수 있었다. O2 RIE 식각 실험을 통해 CBDA 처리한 샘플의 식각 선택도가 크게 향상됨을 확인하였다. 이 방법은 기존에 합성 단계에서 무기물을 도입하는 방법이나 필름상태에서 ALD 공정을 통해 무기물을 도입하여 식각 선택성을 향상시키는 방법에 비해 공정 편의성 및 경제성이 크게 개선된 방법이라 할 수 있다. 향후 본 연구에서 제시된 방법의 실제적 활용을 위해서는 CBDA로 강화된 P2VP 블록을 마스크로 사용하여 종횡비가 높은 패턴을 실제로 구현하는 후속 연구가 진행되어 할 것이며, 추가로 CBDA 뿐 아니라 다양한 무기화합물을 도입하여 식각 저항성을 더욱 높일 수 있는 연구 등이 필요할 것이다.
본 연구에서 제시한 무기화합물의 선택적 결합을 통한 식각 저항성 향상 방법은 비단 PS-b-P2VP 뿐 아니라 유기물로만 이루어진 대부분의 블록공중합체의 낮은 식각 선택도 문제를 극복하는데 많은 참고가 될 수 있을 것이다. 따라서 블록공중합체를 이용한 리소그래피 연구에서 블록을 구성하는 고분자 선택의 자유도를 크게 높일 수 있을 것으며 이는 블록공중합체의 다양한 나노 패턴 주형으로서의 활용성을 더욱 넓힐 수 있을 것으로 기대한다.
- 1. Nunes, S. P.; Car, A. From Charge-Mosaic to Micelle Self-Assembly: Block Copolymer Membranes in the Last 40 Years. Ind. Eng. Chem. Res. 2013, 52, 993-1003.
-

- 2. Uehara, H.; Kakiage, M.; Sekiya, M.; Sakuma, D.; Yamonobe, T.; Takano, N.; Barraud, A.; Meurville, E.; Ryser, P. Size-Selective Diffusion in Nanoporous but Flexible Membranes for Glucose Sensors. ACS Nano 2009, 3, 924-932.
-

- 3. Kim, O.; Kim, S. Y.; Park, B.; Hwang, W.; Park, M. J. Factors Affecting Electromechanical Properties of Ionic Polymer Actuators Based on Ionic Liquid-Containing Sulfonated Block Copolymers. Macromolecules 2014, 47, 4357-4368.
-

- 4. Jeong, C. K.; Baek, K. M.; Niu, S.; Nam, T. W.; Hur, Y. H.; Park, D. Y.; Hwang, G. T.; Byun, M.; Wang, Z. L.; Jung, Y. S.; Lee, K. J. Topographically-Designed Triboelectric Nanogenerator via Block Copolymer Self-Assembly. Nano Lett. 2014, 14, 7031-7038.
-

- 5. Herr, D. J. C. Directed Block Copolymer Self-Assembly for Nanoelectronics Fabrication. J. Mater. Res. 2011, 26, 122-139.
-

- 6. Kim, H. C.; Park, S. M.; Hinsberg, W. D.; Division, I. R. Block Copolymer Based Nanostructures: Materials, Processes, and Applications to Electronics. Chem. Rev. 2010, 110, 146-177.
-

- 7. Hägglund, C.; Zeltzer, G.; Ruiz, R.; Thomann, I.; Lee, H. B. R.; Brongersma, M. L.; Bent, S. F. Self-Assembly Based Plasmonic Arrays Tuned by Atomic Layer Deposition for Extreme Visible Light Absorption. Nano Lett. 2013, 13, 3352-3357.
-

- 8. Cha, S. K.; Mun, J. H.; Chang, T.; Kim, S. Y.; Kim, J. Y.; Jin, H. M.; Lee, J. Y.; Shin, J.; Kim, K. H.; Kim, S. O. Au-Ag Core-Shell Nanoparticle Array by Block Copolymer Lithography for Synergistic Broadband Plasmonic Properties. ACS Nano 2015, 9, 5536-5543.
-

- 9. Park, M.; Harrison, C.; Chaikin, P. M.; Register, R. A.; Adamson, D. H. Block Copolymer Lithography: Periodic Arrays of 1011 Holes in 1 Square Centimeter. Science 1997, 276, 1401-1404.
-

- 10. Darling, S. B. Directing the Self-Assembly of Block Copolymers. Prog. Polym. Sci. 2007, 32, 1152-1204.
-

- 11. Bang, J.; Jeong, U.; Ryu, D. Y.; Russell, T. P.; Hawker, C. J. Block Copolymer Nanolithography: Translation of Molecular Level Control to Nanoscale Patterns. Adv. Mater. 2009, 21, 4769-4792.
-

- 12. Xu, T.; Stevens, J.; Villa, J. A.; Goldbach, J. T.; Guarini, K. W.; Black, C. T.; Hawker, C. J.; Russell, T. P. Block Copolymer Surface Reconstuction: A Reversible Route to Nanoporous Films. Adv. Funct. Mater. 2003, 13, 698-702.
-

- 13. Park, J. H.; Khandekar, A. A.; Park, S. M.; Mawst, L. J.; Kuech, T. F.; Nealey, P. F. Selective MOCVD Growth of Single-Crystal Dense GaAs Quantum Dot Array Using Cylinder-Forming Diblock Copolymers. J. Cryst. Growth 2006, 297, 283-288.
-

- 14. Hirai, T.; Leolukman, M.; Hayakawa, T.; Kakimoto, M. A.; Gopalan, P. Hierarchical Nanostructures of Organosilicate Nanosheets within Self-Organized Block Copolymer Films. Macromolecules 2008, 41, 4558-4560.
-

- 15. Hirai, T.; Leolukman, M.; Liu, C. C.; Han, E.; Kim, Y. J.; Ishida, Y.; Hayakawa, T.; Kakimoto, M. A.; Nealey, P. F.; Gopalan, P. One-Step Direct-Patterning Template Utilizing Self-Assembly of POSS-Containing Block Copolymers. Adv. Mater. 2009, 21, 4334-4338.
-

- 16. Cushen, J. D.; Otsuka, I.; Bates, C. M.; Halila, S.; Fort, S.; Rochas, C.; Easley, J. A.; Rausch, E. L.; Thio, A.; Borsali, R.; Willson, C. G.; Ellison, C. J. Oligosaccharide/Silicon-Containing Block Copolymers with 5 Nm Features for Lithographic Applications. ACS Nano 2012, 6, 3424-3433.
-

- 17. Ross, C. A.; Jung, Y. S.; Chuang, V. P.; Ilievski, F.; Yang, J. K. W.; Bita, I.; Thomas, E. L.; Smith, H. I.; Berggren, K. K.; Vancso, G. J.; Cheng, J. Y. Si-Containing Block Copolymers for Self-Assembled Nanolithography. J. Vac. Sci. Technol. B 2008, 26, 2489.
-

- 18. Jung, Y. S.; Ross, C. A. Solvent-Vapor-Induced Tunability of Self-Assembled Block Copolymer Patterns. Adv. Mater. 2009, 21, 2540-2545.
-

- 19. Bita, I.; Yang, J. K. W.; Jung, Y. S.; Ross, C. A.; Thomas, E. L.; Berggren, K. K. Graphoepitaxy of Self-Assembled Block Copolymers on Two-Dimensional Periodic Patterned Templates. Science 2008, 321, 939-943.
-

- 20. Tavakkoli K. G., A.; Gotrik, K. W.; Hannon, A. F.; Alexander-Katz, A.; Ross, C. A.; Berggren, K. K. Templating Three-Dimensional Self-Assembled Structures in Bilayer Block Copolymer Films. Science 2012, 336, 1294-1298.
-

- 21. Yang, J. K. W.; Jung, Y. S.; Chang, J.-B.; Mickiewicz, R. A; Alexander-Katz, A.; Ross, C. A.; Berggren, K. K. Complex Self-Assembled Patterns Using Sparse Commensurate Templates with Locally Varying Motifs. Nat. Nanotechnol. 2010, 5, 256-260.
-

- 22. Kim, E.; Kim, W.; Lee, K. H.; Ross, C. A.; Son, J. G. A Top Coat with Solvent Annealing Enables Perpendicular Orientation of Sub-10 Nm Microdomains in Si-Containing Block Copolymer Thin Films. Adv. Funct. Mater. 2014, 24, 6981-6988.
-

- 23. Peng, Q.; Tseng, Y. C.; Darling, S. B.; Elam, J. W. Nanoscopic Patterned Materials with Tunable Dimensions via Atomic Layer Deposition on Block Copolymers. Adv. Mater. 2010, 22, 5129-5133.
-

- 24. Materials, N.; Synthesis, S. I.; Templates, B. C. A Route to Nanoscopic Materials via Sequential Infiltration Synthesis on Block Copolymer Templates. ACS Nano 2011, 5, 4600-4606.
-

- 25. Tseng, Y.-C.; Peng, Q.; Ocola, L. E.; Elam, J. W.; Darling, S. B. Enhanced Block Copolymer Lithography Using Sequential Infiltration Synthesis. J. Phys. Chem. C 2011, 115, 17725-17729.
-

- 26. Bucholz, T. L.; Loo, Y. L. Phase Behavior of Near-Monodisperse Semifluorinated Diblock Copolymers by Atom Transfer Radical Polymerization. Macromolecules 2006, 39, 6075-6080.
-

- 27. Hammond, M. R.; Cochran, E.; Fredrickson, G. H.; Kramer, E. J. Temperature Dependence of Order, Disorder, and Defects in Laterally Confined Diblock Copolymer Cylinder Monolayers. Macromolecules 2005, 38, 6575-6585.
-

- 28. Shamsudin, S. A. B.; Sakaguchi, G.; Takenaka, M.; Hasegawa, H. Influence of Temperature and Type of Solvents on the Microdomain Orientation of PS-b-P2VP Ultrathin Films by Solvent Annealing. Macromol. Symp. 2013, 327, 72-79.
-

- 29. Kim, Y. C.; Kim, S. Y. Fabrication of Gold Nanowires in Micropatterns Using Block Copolymers. RSC Adv. 2018, 8, 19532-19538.
-

- 30. Chai, J.; Wang, D.; Fan, X.; Buriak, J. M. Assembly of Aligned Linear Metallic Patterns on Silicon. Nat. Nanotechnol. 2007, 2, 500-506.
-

- 31. Chai, J.; Buriak, J. M. Using Cylindrical Domains of Block Copolymers to Self-Assemble and Align Metallic Nanowires. ACS Nano 2008, 2, 489-501.
-

- 32. Gu, X.; Liu, Z.; Gunkel, I.; Chourou, S. T.; Hong, S. W.; Olynick, D. L.; Russell, T. P. High Aspect Ratio Sub-15 nm Silicon Trenches From Block Copolymer Templates. Adv. Mater. 2012, 24, 5688-5694.
-

- 33. Simon, Y. C.; Moran, I. W.; Carter, K. R.; Coughlin, E. B. Silylcarborane Acrylate Nanoimprint Lithography Resists. ACS Appl. Mater. Interfaces 2009, 1, 1887-1892.
-

- 34. Bratton, D.; Yang, D.; Dai, J.; Ober, C. K. Recent Progress in High Resolution Lithography. Polym. Adv. Technol. 2006, 17, 94-103.
-

- 35. Valkama, S.; Kosonen, H.; Ruokolainen, J.; Haatainen, T.; Torkkeli, M.; Serimaa, R.; Ten Brinke, G.; Ikkala, O. Self-Assembled Polymeric Solid Films with Temperature-Induced Large and Reversible Photonic-Bandgap Switching. Nat. Mater. 2004, 3, 872-876.
-

- 36. Ruokolainen, J.; Ten Brinke, G.; Ikkala, O. Supramolecular Polymeric Materials with Hierarchical Structure-within-Structure Morphologies. Adv. Mater. 1999, 11, 777-780.
-

- 37. Ong, C. W.; Huang, H.; Zheng, B.; Kwok, R. W. M.; Hui, Y. Y.; Lau, W. M. X-Ray Photoemission Spectroscopy of Nonmetallic Materials: Electronic Structures of Boron and BxOy. J. Appl. Phys. 2004, 95, 3527-3534.
-

- 38. Moulder, J. F.; Stickle, W. F.; Sobol, P. E.; Briggs, D. Handbook of X-Ray Photoelectron Spectroscopy; Chastain, J., Ed.; Perkin-Elmer Corporation: Minnesota, 2005; pp 38-39.
- Polymer(Korea) 폴리머
- Frequency : Bimonthly(odd)
ISSN 0379-153X(Print)
ISSN 2234-8077(Online)
Abbr. Polym. Korea - 2023 Impact Factor : 0.4
- Indexed in SCIE
 This Article
This Article
-
2021; 45(2): 314-321
Published online Mar 25, 2021
- 10.7317/pk.2021.45.2.314
- Received on Jan 9, 2021
- Revised on Dec 28, 2020
- Accepted on Feb 1, 2021
 Services
Services
Shared
 Correspondence to
Correspondence to
- Hong Kyoon Choi
-
Division of Advanced Materials Engineering, Kongju National University, Cheonan, Chungnam 31080, Korea
- E-mail: hkchoi@kongju.ac.kr
- ORCID:
0000-0002-2614-0090










 Copyright(c) The Polymer Society of Korea. All right reserved.
Copyright(c) The Polymer Society of Korea. All right reserved.